半导体薄膜非接触测厚仪
简要描述:NS-30半导体薄膜非接触测厚仪是一款基于白光干涉原理的高精度测量设备,特别适用于需要自动化测量和精准厚度分布分析的场景。
详细介绍
| 价格区间 | 20万-50万 | 产地类别 | 国产 |
|---|
| 应用领域 | 生物产业,能源,电子/电池,包装/造纸/印刷,航空航天 | | |
|---|
NS-30半导体薄膜非接触测厚仪是一款基于白光干涉原理的高精度测量设备,特别适用于需要自动化测量和精准厚度分布分析的场景。
1、核心原理
垂直入射的高稳定宽波段光入射到样品表面,在各膜层之间产生光学干涉现象,反射光经过光谱分析以及回归算法可计算出薄膜各层的厚度。适合测量纳米级至微米级的透明或半透明膜层的厚度、反射率、折射率等参数。
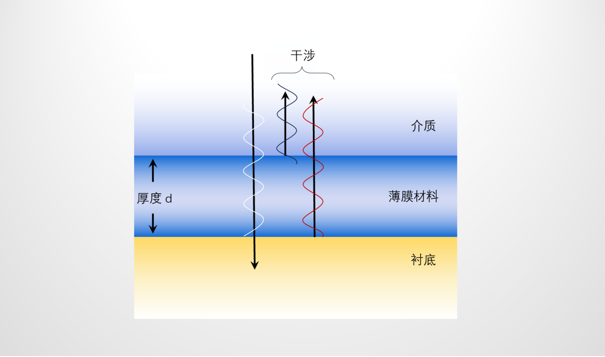
2、具体参数
- 核心原理:垂直入射宽波段白光干涉技术
- 测量范围:1 nm 至 250 μm
- 波长范围 (NIP型号):950 nm - 1700 nm (近红外波段)
- 准确度:3 nm 或 0.4%
- 重复精度:0.1 nm
- 测量速度:< 1秒/单点
- 光斑大小:1.5 mm
- 核心特色:自动样品载台,可预设点位进行自动测量,并生成厚度、折射率、反射率的2D/3D分布图
- 样品台尺寸:100mm 至 450mm 可选
- 测量能力:可测量多层复合薄膜各层的厚度、折射率(n)和反射率
3、核心功能

4、实测结果展示
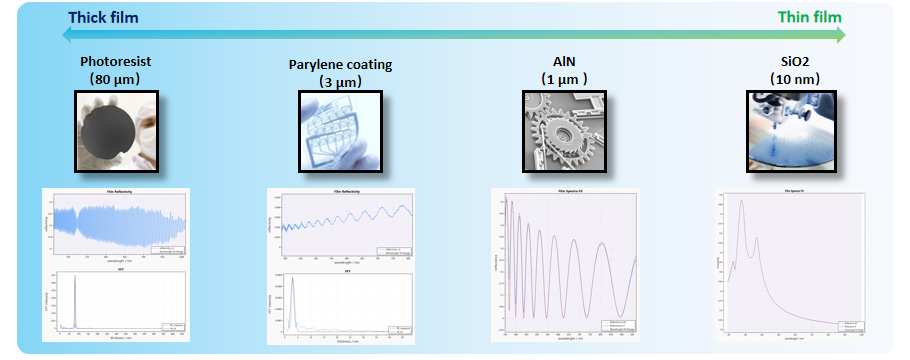
在线留言